隨著目前產(chǎn)品小型化的需求越來越多,且可穿戴設(shè)備的逐漸普及,工程師們對于芯片小型化的需求也越來越強烈,這個就涉及到了芯片的封裝工藝。這次,我們只針對NAND flash的封裝進行介紹。
芯片常用封裝有:DIP、QFP、PFP、PGA、BGA、TSOP、COB等封裝。這里主要介紹NAND FLASH常用的三種封裝(TSOP、BGA、COB)。

1.TSOP封裝
TSOP是“Thin Small Outline Package”的縮寫,意思是薄型小尺寸封裝。TSOP內(nèi)存是在芯片的周圍做出引腳,采用SMT技術(shù)(表面安裝技術(shù))附著在PCB板的表面,裝配高度不到1.27mm。具體到FLASH這類型芯,工藝主要是把FLASH晶圓固定在鋼板框架上,然后通過打線把晶圓上的點連接到框架的PIN腳上,再對表面進行注膠。
目前的最高的封閉技術(shù)能把四顆晶圓封閉在一個TSOP 的FLASH內(nèi)。此種TSOP封裝的FLASH相對較厚。TSOP特點:電流大幅度變化時,引起輸出電壓較小,適合高頻應(yīng)用,操作比較方便(如方便手工貼片或拆片及反復(fù)利用),可靠性也比較高。同時TSOP封裝具有成品率高。價格相對COB高,因此得到了極為廣泛的應(yīng)用。
2.COB封裝
COB(chip on board) 板上芯片封裝,是裸芯片貼裝技術(shù)之一。半導(dǎo)體芯片交接貼裝在印刷線路板上,芯片與PCB板是通過邦定連接的方法實現(xiàn)。NAND FLASH行業(yè)使用COB的封裝方式主要是節(jié)省成本考慮。工程師先把外圍電氣走線畫好,然后在PCB板上點紅膠,把晶圓按指定方向及位置貼好。
然后使用邦定機對晶圓進行邦定。確認邦定電氣性能良好后,對晶圓表面及PCB板部分進行樹脂覆蓋固定。COB 是最簡單的裸芯片貼裝技術(shù),但它的封裝密度遠不如TSOP和BGA技術(shù)。
3.BGA封裝
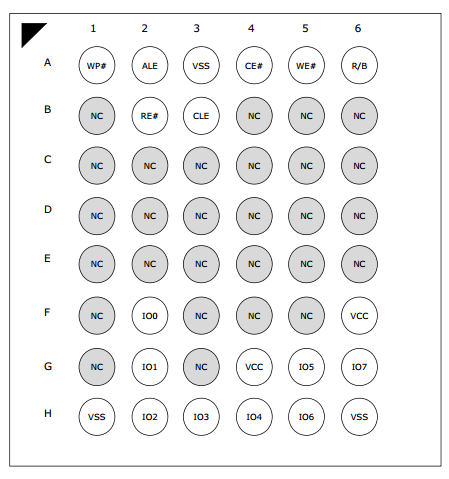
BGA(ball grid array) 球形觸點陳列,表面貼裝型封裝之一。在印刷基板的背面按陳列方式制作出球形凸點用以 代替引腳,在印刷基板的正面裝配NANDflash 芯片,然后用模壓樹脂或灌封方法進行密封。封裝本體也可做的比QFP(四側(cè)引腳扁平封裝)小。
BGA主要特點:1、I/O引腳數(shù)雖然增多,但引腳之間的距離遠大于QFP封裝方式,提高了成品率 2、雖然BGA的功耗增加,但由于采用的是可控塌陷芯片法焊接,從而可以改善電熱性能 3、信號傳輸延遲小,適應(yīng)頻率大大提高 4、組裝可用共面焊接,可靠性大大提高。此封閉應(yīng)用在NAND FLASH方面,主要影響是:1、可針對一些大尺寸晶圓進行封裝。2、減小NAND flash封裝片的面積,適用于對于主板尺寸要求嚴格的產(chǎn)品,特別是近些年來的可穿戴設(shè)備,對于產(chǎn)品尺寸的要求相當嚴格。3、此封閉大部分為原裝片使用。黑片相對較少使用BGA。
從上面可以看出BGA的封裝是比較適合小型化需求的,以韓國ATO solution公司為例,1Gb容量的NAND flash,BGA的最小尺寸可以做到6.5 X 8 mm (48ball),普通的1Gb NAND flash的尺寸為9 X 9 mm(48ball)。對于產(chǎn)品空間要求比較苛刻的客戶可以選擇。