摘要
目前主流的基于浮柵閃存技術(shù)的非易失性存儲(chǔ)器(NVM)技術(shù)有望成為未來幾年的參考技術(shù)。但是,閃存本身固有的技術(shù)和物理局限性使其很難再縮小技術(shù)節(jié)點(diǎn)。在這種環(huán)境下,業(yè)界試圖利用新材料和新概念發(fā)明一種更好的存儲(chǔ)器技術(shù),以替代閃存技術(shù),更有效地縮小存儲(chǔ)器,提高存儲(chǔ)性能。這篇文章將分析新的主要的基于無機(jī)材料的非易失性存儲(chǔ)器技術(shù),如鐵電存儲(chǔ)器 (FeRAM)、磁阻存儲(chǔ)器(MRAM)和相變存儲(chǔ)器(PCM),以及主要的基于鐵電或?qū)щ婇_關(guān)聚合物等有機(jī)材料的創(chuàng)新存儲(chǔ)器概念。最后,我們重點(diǎn)探討相變存儲(chǔ)器技術(shù),因?yàn)樵摷夹g(shù)最有可能成為下一代非易失性存儲(chǔ)器技術(shù),同時(shí)我們將分析相變存儲(chǔ)器技術(shù)的主要特性和最新的發(fā)展?fàn)顩r。
前言
在高速成長(zhǎng)的非易失性存儲(chǔ)器(NVM)市場(chǎng)的推動(dòng)下,十年來,世界上出現(xiàn)了幾項(xiàng)具有突破性的存儲(chǔ)器技術(shù),使業(yè)界標(biāo)準(zhǔn)技術(shù)被淘汰出局,并擴(kuò)大了閃存技術(shù)的應(yīng)用領(lǐng)域[1]。業(yè)內(nèi)廣泛接受的觀點(diǎn)是,任何一項(xiàng)技術(shù)如果取得成功,就會(huì)在未來十年內(nèi)變?yōu)楫a(chǎn)品。目前,業(yè)界對(duì)兩大類全新的非易失性存儲(chǔ)器進(jìn)行了可行性調(diào)研,其中一類是基于無機(jī)材料的存儲(chǔ)器技術(shù),如鐵電存儲(chǔ)器(FeRAM)、磁阻存儲(chǔ)器(MRAM)或相變存儲(chǔ)器(PCM),另一類存儲(chǔ)器技術(shù)則基于有機(jī)材料,鐵電或?qū)щ婇_關(guān)聚合物。值得注意的是,眼看這個(gè)十年就要結(jié)束,在這些接替閃存的非易失性存儲(chǔ)器當(dāng)中,只有相變存儲(chǔ)器具備進(jìn)入廣闊市場(chǎng)的能力表現(xiàn),被視為下一個(gè)十年的主流存儲(chǔ)器技術(shù)。
替代閃存的非易失性存儲(chǔ)器
在目前已調(diào)研的兩大類新的非易失性存儲(chǔ)器技術(shù)中,基于鐵電或?qū)щ婇_關(guān)聚合體的有機(jī)材料的存儲(chǔ)器技術(shù)還不成熟,處于研發(fā)階段。某些從事這類存儲(chǔ)器材料研究的研發(fā)小組開始認(rèn)為,這個(gè)概念永遠(yuǎn)都不會(huì)變成真正的產(chǎn)品。事實(shí)上,使這些概念符合標(biāo)準(zhǔn)CMOS集成要求及其制造溫度,還需要解決幾個(gè)似乎難以逾越的挑戰(zhàn)。另一方面,業(yè)界對(duì)基于無機(jī)材料的新非易失性存儲(chǔ)器概念的調(diào)研時(shí)間比較長(zhǎng),并在過去幾年發(fā)布了幾個(gè)產(chǎn)品原型。
早在上個(gè)世紀(jì)90年代就出現(xiàn)了FeRAM技術(shù)概念。雖然在研究過程出現(xiàn)過很多與新材料和制造模塊有關(guān)的技術(shù)難題,但是,經(jīng)過十年的努力,即便固有的制程縮小限制,技術(shù)節(jié)點(diǎn)遠(yuǎn)遠(yuǎn)高于閃存,鐵電存儲(chǔ)器現(xiàn)在還是實(shí)現(xiàn)了商業(yè)化。這個(gè)存儲(chǔ)器概念仍然使用能夠被電場(chǎng)極化的鐵電材料。溫度在居里點(diǎn)以下時(shí),立方體形狀出現(xiàn)晶格變形,此時(shí)鐵電體發(fā)生極化;溫度在居里點(diǎn)以上時(shí),鐵電材料變成順電相。到目前為止,業(yè)界已提出多種FeRAM單元結(jié)構(gòu)(如圖1所示),這些結(jié)構(gòu)屬于兩種方法體系,一種是把鐵電材料集成到一個(gè)單獨(dú)的存儲(chǔ)元件內(nèi),即鐵電電容器內(nèi)(在雙晶體管/雙電容(2T2C)和單晶體管/單電容(1T1C)兩種元件內(nèi)集成鐵電材料的方法)[2],另一種是把鐵電材料集成到選擇元件內(nèi),即鐵電場(chǎng)效應(yīng)晶體管[3]內(nèi)。所有的FeRAM架構(gòu)都具有訪存速度快和真證的隨機(jī)訪問所有存儲(chǔ)單元的優(yōu)點(diǎn)。今天,F(xiàn)eRAM技術(shù)研發(fā)的主攻方向是130nm制程的64Mb存儲(chǔ)器[4]。
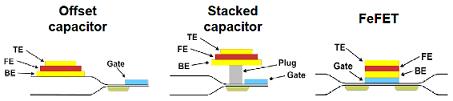
圖1 – FeRAM單元架構(gòu)方案
多年來,磁隧道結(jié)(MTJ)存儲(chǔ)單元(如圖2所示)一直是MRAM研發(fā)人員的主要研發(fā)工作[5],MTJ由一個(gè)晶體管和一個(gè)電阻組成(1T/1R)。這些技術(shù)是利用隧道結(jié)與磁阻材料整合產(chǎn)生的特殊效應(yīng):當(dāng)施加一個(gè)磁場(chǎng)時(shí),電阻就會(huì)發(fā)生變化。訪存速度極快的無損性讀取性能是確保高性能、讀寫次數(shù)相同和低功耗操作的前提。MRAM的主要缺點(diǎn)是該技術(shù)固有的寫操作電流過高和技術(shù)節(jié)點(diǎn)縮小受限。為了克服這兩大制約因素,業(yè)界最近提出了自旋轉(zhuǎn)移矩RAM(SPRAM)解決方案[6],這項(xiàng)創(chuàng)新技術(shù)是利用自旋轉(zhuǎn)換矩引起的電流感應(yīng)式開關(guān)效應(yīng)。盡管這一創(chuàng)新方法在一定程度上解決了MRAM的一些常見問題,但是還有很多挑戰(zhàn)等待研究人員克服(例如:自讀擾動(dòng)、寫次數(shù)、單元集成等),今天,MRAM的制造只局限于4Mb陣列180nm制程的產(chǎn)品[7]。
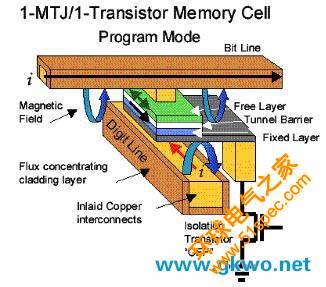
圖2 – 采用MTJ 1T1R方法的MRAM單元架構(gòu)[5]
相變存儲(chǔ)器
PCM是最好的閃存替代技術(shù),能夠涵蓋不同的非易失性存儲(chǔ)器應(yīng)用領(lǐng)域,滿足高性能和高密度兩種應(yīng)用要求。PCM利用溫度變化引起硫系合金(Ge2Sb2Te5)相態(tài)逆變的特性。 基本單元結(jié)構(gòu)由一個(gè)晶體管和一個(gè)電阻構(gòu)成(1T/1R),利用電流引起的焦耳熱效應(yīng)(圖3-a)對(duì)單元進(jìn)行寫操作,通過檢測(cè)非晶相態(tài)和多晶相態(tài)之間的電阻變化讀取存儲(chǔ)單元。雖然這項(xiàng)技術(shù)最早可追溯到上個(gè)世紀(jì)70年代,但是直到最近人們才重新嘗試將其用于非易失性存儲(chǔ)器[9](采用相變合金的光電存儲(chǔ)設(shè)備取得商業(yè)成功,也促進(jìn)了人們發(fā)現(xiàn)性能更優(yōu)異的相變材料結(jié)構(gòu)的研究活動(dòng)),相變存儲(chǔ)器證明其具有達(dá)到制造成熟度的能力[10]。我們?cè)诒疚暮竺娴谋砀裰斜容^了相變存儲(chǔ)器與其它的成熟的非易失性存儲(chǔ)器技術(shù)。 融非易失性存儲(chǔ)器和DRAM兩大存儲(chǔ)器的優(yōu)點(diǎn)于一身,PCM的新特性對(duì)新型應(yīng)用很有吸引力,同時(shí)還是一項(xiàng)具有連續(xù)性和突破性的存儲(chǔ)器技術(shù)。從應(yīng)用角度看,PCM可用于所有的存儲(chǔ)器系統(tǒng),特別適用于消費(fèi)電子、計(jì)算機(jī)、通信三合一電子設(shè)備的存儲(chǔ)器系統(tǒng) [11]。具體地講,在無線系統(tǒng)中,PCM可用作代碼執(zhí)行存儲(chǔ)器;PCM可用作可改寫只讀存儲(chǔ)器,保存處理頻率最高的數(shù)據(jù)結(jié)構(gòu)以外的全部數(shù)據(jù)結(jié)構(gòu),在固態(tài)存儲(chǔ)子系統(tǒng)中,保存經(jīng)常訪問的頁面;在立即處理數(shù)據(jù)時(shí),保存更容易管理的數(shù)據(jù)元素;計(jì)算機(jī)平臺(tái)可利用其非易失性。

圖3a - PCM原型結(jié)構(gòu)的被寫存儲(chǔ)單元的自加熱示意圖[8]
PCM的技術(shù)發(fā)展路線如圖4所示。業(yè)界利用180nm技術(shù)節(jié)點(diǎn)開發(fā)出了首個(gè)芯片測(cè)試載具,并驗(yàn)證了此項(xiàng)技術(shù)的可行性[12]。BJT選定的單元被高性能和高密度存儲(chǔ)器選用,因?yàn)閱卧叽缈梢允莮5F2 (其中F是存儲(chǔ)單元半節(jié)距最小值)。雖然單元尺寸較大(~20F2),但是集成存儲(chǔ)器只需在邏輯制程中增加很少的掩模,成本優(yōu)勢(shì)十分突出,因此,MOS選定的單元適用于系統(tǒng)芯片或嵌入式應(yīng)用[13]。
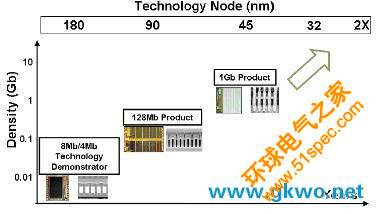
圖4 - PCM技術(shù)發(fā)展路線圖
英特爾和意法半導(dǎo)體開發(fā)出一款叫做Alverstone的128Mb的90nm相變存儲(chǔ)器,該產(chǎn)品現(xiàn)已實(shí)現(xiàn)商業(yè)化[14]。另外一款 45nm 1Gb PCM產(chǎn)品現(xiàn)已進(jìn)入高級(jí)研發(fā)階段,該產(chǎn)品設(shè)計(jì)的單元尺寸為5.5F2 (圖3-b) [15]。

圖3 b - 45nm技術(shù)PCM陣列的截面圖[15]
PCM技術(shù)研發(fā)將沿著不同的路線并行前進(jìn)。主流的開發(fā)路線將是采用BJT選定的單元,沿著光刻技術(shù)發(fā)展路線,縮小現(xiàn)有技術(shù)架構(gòu),提供最小的單元尺寸。除廣泛使用的 Ge2Sb2Te5以外,利用新的硫系合金是另外一個(gè)重要的研究領(lǐng)域,因?yàn)檫@可能會(huì)開創(chuàng)全新的應(yīng)用領(lǐng)域;結(jié)晶速度極快或結(jié)晶溫度更高的合金將會(huì)更有吸引力[16]。
在存儲(chǔ)器架構(gòu)方面,一條研究主線將是利用真正的交叉點(diǎn)陣列,實(shí)現(xiàn)一層以上的存儲(chǔ)器疊層。通過在后工序中集成p-n結(jié)或肖特基二極管作為選擇元件,業(yè)界已經(jīng)提出了不同的解決方法[17-18]。硫系材料特別適合這種堆疊方法,因?yàn)樵诹蛳挡牧隙询B后,其相變特性(像Ge2Sb2Te5)可以構(gòu)成存儲(chǔ)器元件,同時(shí)其電子開關(guān)特性(像OTS)構(gòu)成選擇元件[19](圖5)。在這種情況下,單元尺寸可以達(dá)到4F2,位大小是單元尺寸的幾分之一,具體大小取決于疊層數(shù)量[19],這項(xiàng)技術(shù)適用于高密度存儲(chǔ)器,特別是存儲(chǔ)應(yīng)用。

圖5 - 一層采用CMOS技術(shù)全集成的交叉點(diǎn)PCM陣列
總之,現(xiàn)有的技術(shù)成熟度,技術(shù)節(jié)點(diǎn)縮小能力,更廣泛的應(yīng)用范圍,而且新材料和新架構(gòu)可進(jìn)一步擴(kuò)大應(yīng)用范圍,這一切為相變存儲(chǔ)器技術(shù)未來十年在存儲(chǔ)器市場(chǎng)發(fā)揮重要作用鋪平了道路。
參考文獻(xiàn)
[I]R.Bez, “Chalcogenide PCM: a memory technology for next decade”, IEDM Tech. Dig., 2009.
[2] S.-H. Oh et al., “Noble FeRAM Technologies with MTP Cell Structure and BLT Ferroelectric Capacitors”, IEDM Tech. Dig., 2003, p. 835, 2003.
[3] H. Ishiwara, ” Recent Progress in FET-type Ferroelectric Memories”, IEDM Tech. Dig., 2003, p. 263, 2003. [4] H. McAdams et al., “A 64Mbit Embedded FeRAM Utilizing a 130nm, 5LM Cu/FSG Logic Process”, Symp. On VLSI Tech., 2003.
[5] M. Durlam et al., “A 0.18μm 4Mb Toggling MRAM”, IEDM Tech. Dig., 2003, p. 995, 2003. [6] M. Hosomi et al., “A Novel Nonvolatile Memory with Spin Torque Transfer Magnetization Switching: Spin-RAM”, IEDM Tech. Dig., 2005. [7] See www.everspin.com
[8] A. Redaelli et al., “Threshold switching and phase transition numerical models for phase change memory simulations”, J. Appl. Phys., vol. 103, 111101, 2008.
[9] S. Lai and T.Lowrey., “OUM - A 180 nm Nonvolatile Memory Cell Element Technology for Stand Alone and Embedded Applications”, IEDM Tech. Dig. 2001, p. 803, 2001.
[10] A. Pirovano et al., “Self-Aligned μTrench Phase-Change Memory Cell Architecture for 90nm Technology and Beyond”, Proc. ESSDERC 07., p. 222, 2007.
[II] S.Eilert et al., “Phase Change Memory: a new memory enables new memory usage models”, 2009 IEEE IMW, Monterey, pag.72 , 2009.
[12] F.Pellizzer et al., “Novel uTrench PCM cell for embedded and stand-alone NVM applications”, Symp. On VLSI Tech., pag.18, 2004.
[13] R.Annunziata et al., “Phase Change Memory Technology for Embedded Non Volatile Memory Applications for 90nm and Beyond”, IEDM Tech. Dig., 2009.
[14] F.Pellizzer et al.,, “A 90nm Phase-Change Memory Technology for Stand-Alone Non-Volatile Memory Applications”, Symp. on VLSI Tech., pag.122, 2006.
[15] G.Servalli, “A 45nm Generation Phase Change Memory Technology”, IEDM Tech. Dig., 2009.
[16] R.Bez, “Development Lines for Phase Change Memories”, EPCOS 2008, Prague (http//www.epcos.org).
[17] Y.Sasago et al., “Cross-point pcm with 4F2 cell size driven by low-contact-resistivity poly-Si diode”, Symp.VLSI Tech., T2B1, 2008.
[18] G.Tallarida et al., “Low temperature rectifying junctions for crossbar non-volatile memory devices”, IMW, Monterey, 2009.
[19] S.R.Ovshinsky, “Reversible electrical switching phenomena in disordered structures”, Phys. Rev. Lett. 21, pag.1450, 1968.
[20] D.Kau et al., “A Stackable Cross Point Phase Change Memory”, IEDM Tech. Dig., 2009.